2016/02/24
~世界初、周辺への不要な光の反射を抑え、パターン周辺部分の微細化を実現~
凸版印刷株式会社(本社:東京都千代田区、代表取締役社長:金子眞吾、以下 凸版印刷)は、次世代半導体製造技術であるEUV露光(※1)において、周辺部への不要な光の反射を抑え、最先端半導体に対応した次世代EUVフォトマスクを開発しました。
2016年度内に半導体メーカーへのサンプル出荷を行うとともに、2017年度の本格的な量産を開始する予定です。今後、本技術を活用し次世代EUVフォトマスクの業界標準化を目指します。
なお、周辺への不要な光の反射を抑える構造をEUVフォトマスクの表面に作製し、パターン周辺部分の微細化を実現したことは、世界初となります。
また、この開発に関して2016年2月22日から2月25日まで米国カリフォルニア州サンノゼで開催される国際学会「SPIE Advanced Lithography 2016」(会場:San Jose Convention Center)で発表する予定です。
■ 背景
ビッグデータの分析や人工知能の利用、自動車の自動運転技術の実用化など、半導体の高性能化のニーズが高まるなか、次世代の半導体製造技術であるEUV露光に注目が集まっています。EUV露光が実用化されることで、半導体の微細化が進み、現在よりも小型・高速・低消費電力のプロセッサーを製造することが可能となります。
EUV露光による半導体の製造プロセスでは、光源からの光がEUVフォトマスクによって反射され、シリコン基板上にパターンを形成します。光源からの光には、パターニングに必要なEUV光だけでなく、パターニングに不必要な様々な波長の光(アウト・オブ・バンド、以下 OOB光)も含まれています。
このOOB光によりシリコン基板上のパターン周辺部分が正確に形成されない、という問題がありました。
この問題を解決するため、凸版印刷はEUVフォトマスク上のパターン外周部に配置され、EUV光の不要な反射を抑える遮光帯(※2)とよばれる部分に改良を加えました。凸版印刷の保有する微細加工技術や光学設計技術を発展・融合させ、特殊な3次元構造をEUVフォトマスク上の遮光帯部分に製作し、より光源からの光を制御した次世代EUVフォトマスクを開発しました。
凸版印刷は、世界トップのフォトマスクメーカーです。最先端フォトマスクを提供することで半導体メーカーの最先端プロセスの立ち上げから量産まで広く支援をしてきました。EUVフォトマスクにおいては、2012年に業界標準となっている従来のEUVフォトマスクを開発し、このたび微細化を進めた次世代EUVフォトマスクの開発に成功しました。今後も研究開発を続け、半導体製造技術の進化に貢献していきます。
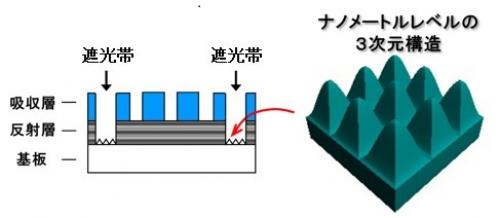
© Toppan Printing Co., Ltd.
■ 特長
特殊な3次元構造により光の反射を抑え、歩留まり向上を実現
凸版印刷の保有する微細加工技術や光学設計技術を発展・融合させ、世界で初めてEUVフォトマスク表面の遮光部分に特殊な3次元構造を形成し、従来品と比較してOOB光の反射を約70%削減しました。また、ASML社(※3)のEUV露光機を用いた転写テストの結果、本開発品によりシリコン基板上の寸法変動を3分の1に削減できることを実証しました。
これらの結果、半導体パターンの品質向上と歩留まり向上を実現します。
表 従来EUVフォトマスクと次世代EUVフォトマスクの反射率比較(遮光帯部)
| マスクの種類 | EUV光の反射率 | OOB光の反射率 |
| 従来EUVフォトマスク | 0.05%未満(測定限界以下) | 5~6% |
| 次世代EUVフォトマスク | 0.05%未満(測定限界以下) | 1.5%以下 |
■ 今後の目標
凸版印刷は2016年度内に顧客である世界の半導体メーカーへサンプル出荷を開始します。
さらに開発を進め、量産ターゲットである2017年以降の実用化と業界標準となることを目指します。
※1 EUV露光
半導体の回路パターンをシリコン基板上に転写する露光技術の1つ。波長が13.5ナノメートル(ナノは10億分の1)の極端紫外線(extreme ultraviolet)とよばれる光を用いた露光方式。
※2 遮光帯
EUVフォトマスク上のパターン外周部に配置されるEUV光の不要な反射を抑えた領域
※3 ASML社
オランダに本社を置く、世界で唯一の半導体製造用EUV露光機のメーカー。
※ 本ニュースリリースに記載された技術は特許出願中です。
※ 本ニュースリリースに記載された会社名および商品・サービス名は各社の商標または登録商標です。
※ 本ニュースリリースに記載された内容は発表日現在のものです。その後予告なしに変更されることがあります。
