半導体パッケージ基板とは
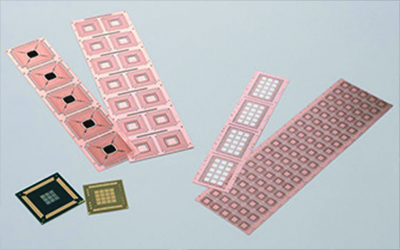
繊細なICチップを外部環境から保護し、プリント配線板に実装する際の外部接続配線端子を提供する役割を果たすのが、半導体パッケージです。
AI・クラウドコンピューティング・自動車のインテリジェント化など、急速なエレクトロニクス技術進展にともなうICの高速化・高集積化・低消費電力化の要求や、スマートホン・ウエアブルデバイスに代表される電子機器の小型化・薄型化により、半導体パッケージにも高多層化・微細化・低背化が求められています。トッパンは、長年培った高度なフォトリソグラフィー技術とエッチング技術を基に、半導体パッケージ用サブストレートの研究開発と製造を行っています。
代表的な半導体パッケージと構造
-
リードフレーム
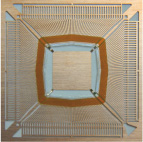
フレーム中心部のダイパッドの上に、シリコンウエハから切り出したICチップ(ダイ)を固定し、リードと金線などのワイヤーで接続して、モールド樹脂で封止されています。
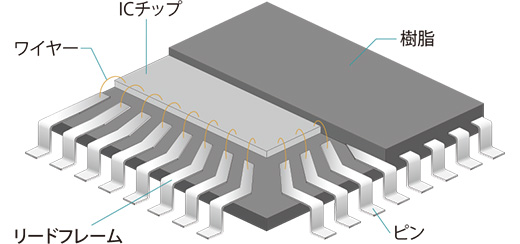
-
FC-BGA
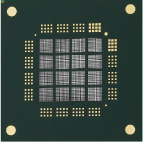
サブストレート中心部のはんだバンプ(突起状の接続電極)の上に、シリコンウエハから切り出したICチップ(ダイ)を接続、アンダーフィル樹脂で封止されています。
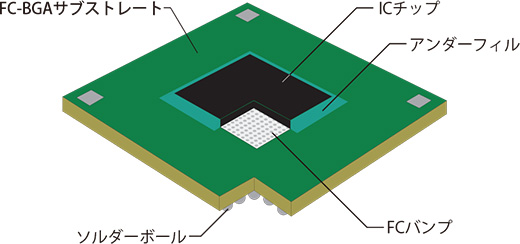
TOPPANは、半導体プロセスの微細化に対応した超高密度配線構造のFC-BGAサブストレートの開発・製造に取り組んでいます。
半導体パッケージの変遷
半導体パッケージには、1,高密度実装のためのパッケージの小型化 2,高集積化、多機能化のための多ピン化 3,高機能化に伴う高放熱性、高電気特性が要求されています。トッパンではめまぐるしく進化する半導体パッケージの市場ニーズに応じた様々な製品を提供しています。